
散热系统对于智能手机的使用体验、使用寿命至关重要。随着5G时代的到来,智能手机的发展,如今手机厂商越来越重视散热系统的设计与改善。今天我们就以小米10的散热设计架构为例,简述智能手机PCB设计上如何改善散热。
小米10 智能手机热设计架构
小米10智能手机的热设计核心理念可以概况为“均温和高效热传导”。如图1所示,是小米10揭掉后盖之后的内部结构图。在后壳内侧布置了大面积的石墨片,从而保证后壳温度的均匀性。同时,在NFC线圈和无线充电模块区域也布置了多层石墨片,在进行无线充电时,降低模块区域的温度。
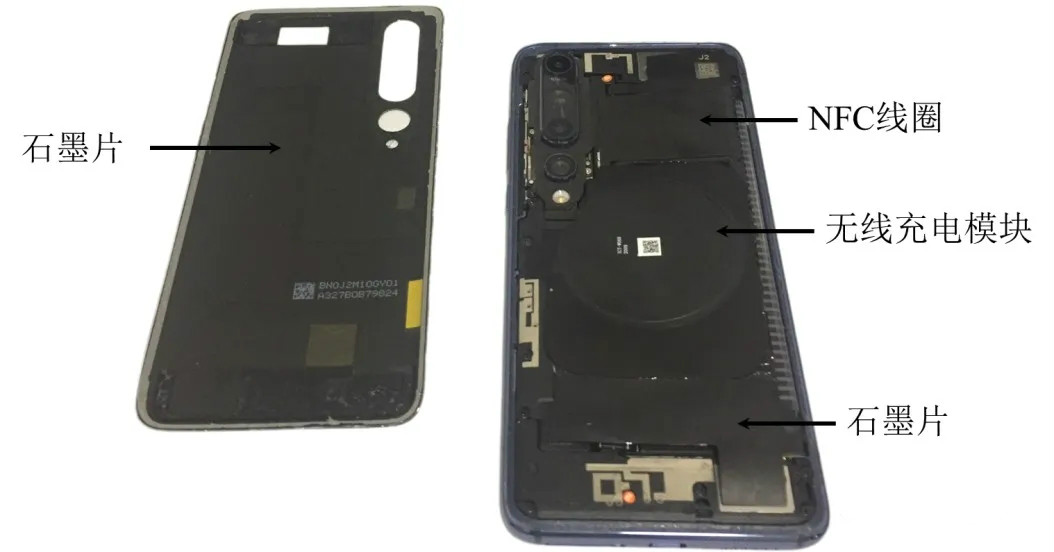
图1 揭掉后盖的小米10内部结构
在翻折NFC和无线充电模块之后,可以看到内部的4500mAh电池和主板盖板。其中主板盖板的局部区域也覆盖有铜箔用以均温,如图2所示。

图2 主板盖板铜箔均温
如图3为去除镜头保护盖板和主板盖板之后的内部结构。小米10在主板区采用双层主板的设计,主板下方堆叠一块小板。主板盖板的铜箔所在位置正对小板,铜箔的主要作用是辅助小板的散热。镜头保护盖板的下方为石墨片,对应的是热功耗较高的主摄区域。

图3 去除镜头保护盖板和主板盖板的小米10内部结构
堆叠的小板底面(靠近后盖侧)覆盖有铜箔,正面涂覆有导热硅脂。主板元件的屏蔽盖上方依次是铜箔和石墨片,并且通过导热硅脂与堆叠小板进行良好的热传导,如图4。
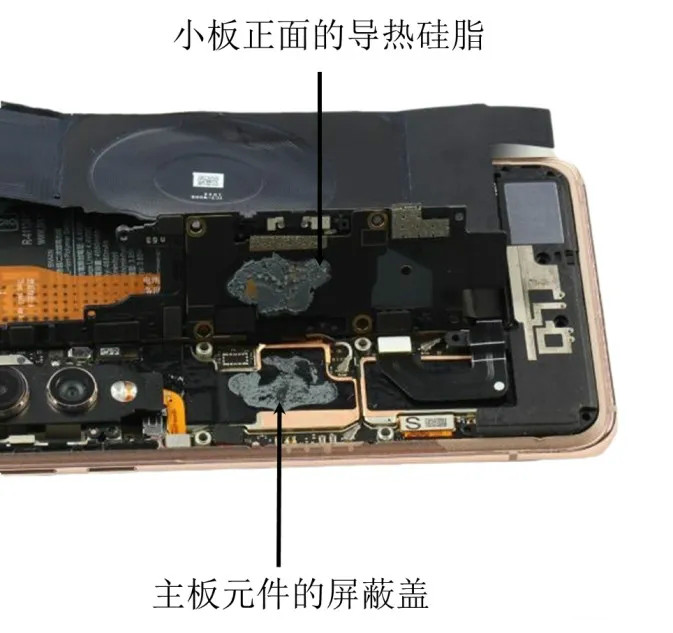
图4 双层主板之间的传导
主板正面和底面两侧均布置有高热功耗元件。主板正面元件屏蔽盖上采用了铜箔进行均温,在手机中框对应主板的区域采用VC均温板和导热凝胶,保证主板正面元件的热功耗可以有效传递至VC均温板,如图13左图所示。主板底面的元件屏蔽盖上方采用了铜箔、石墨片和石墨烯导热垫进行散热和均温,如图5右图所示。
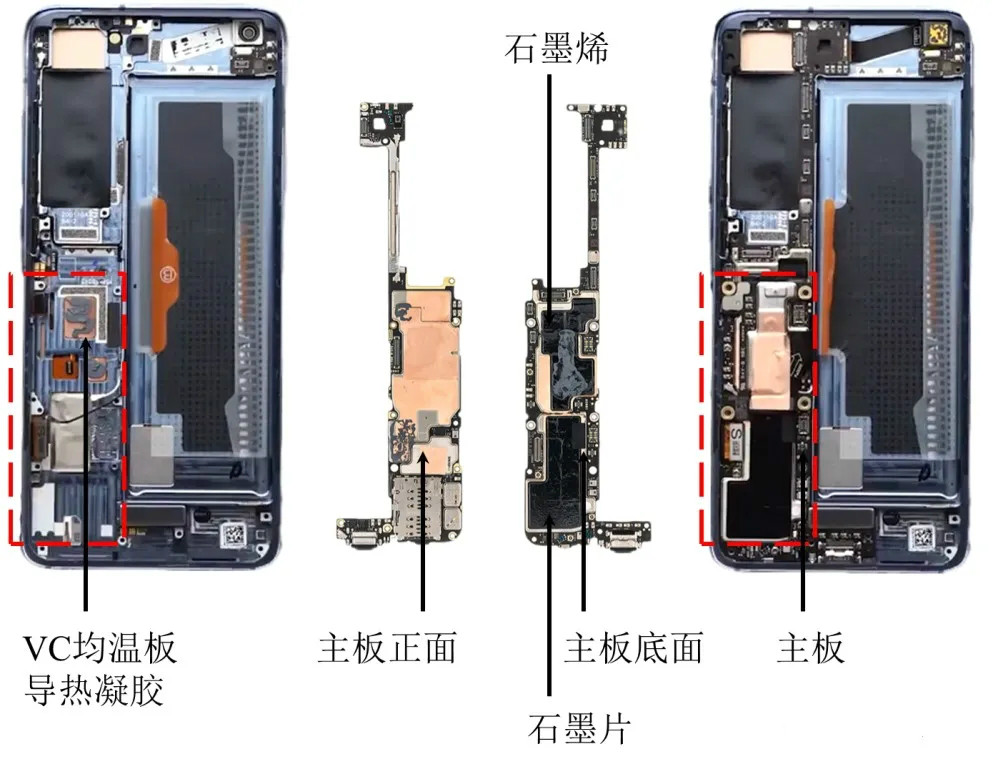
图5 主板的散热结构
为了避免主板上芯片和电路的电磁场向外辐射引起干扰,在芯片上方会使用屏蔽盖。图6右图为骁龙865局部放大图。其中屏蔽盖与865芯片顶面之间存在有一定的间隙。为了改善芯片与屏蔽盖之间的热传导,在这两者之间填充有导热凝胶,如图7所示。
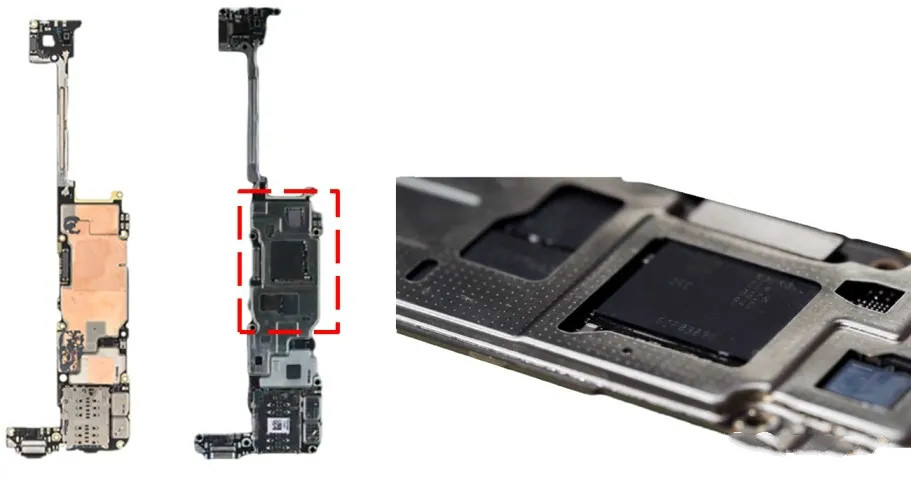
图6 主板屏蔽盖

图7 芯片与屏蔽盖之间填充导热凝胶
小米10的四摄模组位于手机的左上方,如图8左所示,四摄模组的底面采用了铜箔进行均温。此外,在手机中框对应四摄模组的区域使用了大面积的铜箔和石墨片,确保四摄模组的热功耗传导至中框之后不会产生热点区域。
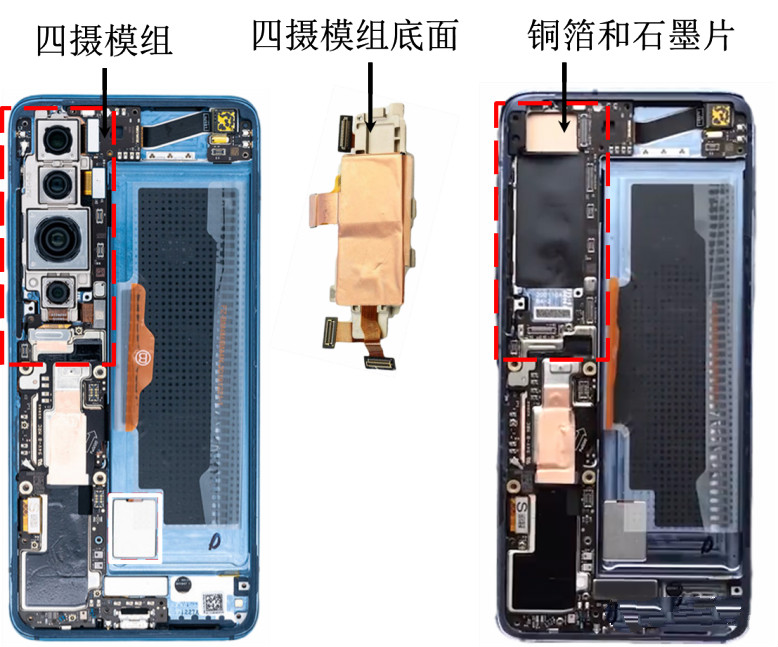
图8 四摄模组的主要散热结构
如图9所示,是小米10去掉显示屏之后的内部结构图。在显示屏内侧布置了大面积的铜箔,从而保证显示屏表面温度的均匀性。同时,手机中框使用了大面积的VC均温板和石墨片,尽量使中框具有良好的散热和均温性能。

图9 揭掉显示屏的小米10内部结构
小米10几乎采用了所有主流的导热界面材料来构建整个散热系统,这些界面材料形成了两条由内至外顺畅的热流路径。如图10所示,位于主板正面的芯片A的热功耗通过热传导的方式经过导热凝胶、屏蔽盖、铜箔、导热凝胶、VC均温板、铜箔至显示屏表面,最终通过自然对流或热辐射的方式进入至环境中。同理,位于主板底面的芯片B的热功耗通过层层材料至后盖表面,最终通过自然对流或热辐射的方式进入至环境中。小米10将内部高效热传导几乎做到了极致。
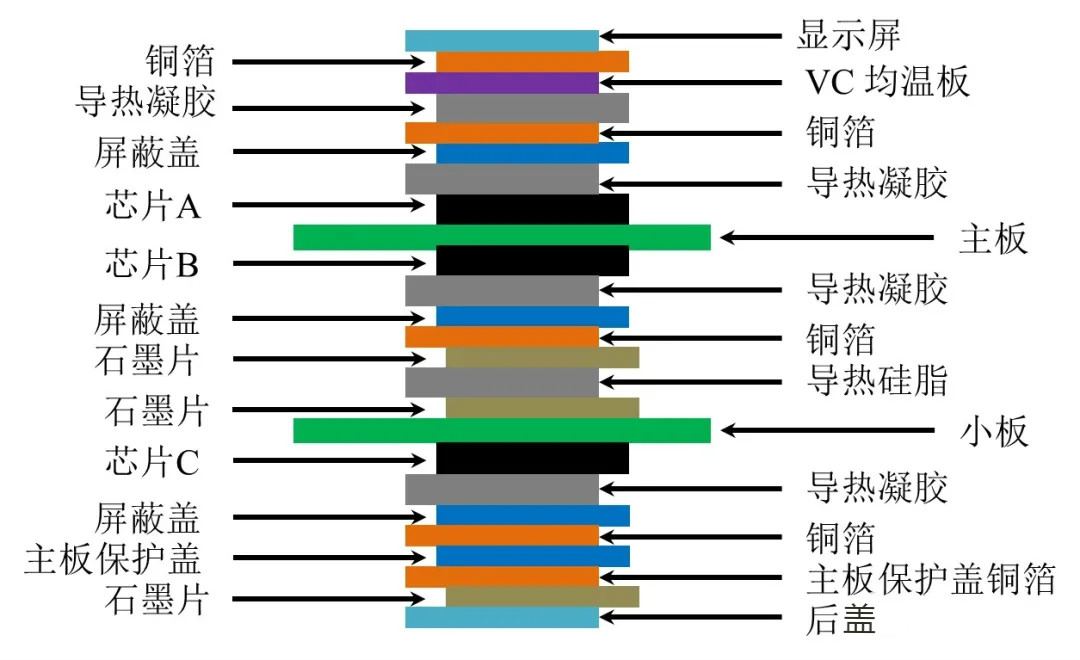
图10 主板芯片热流路径
从智能手机散热设计过渡到PCB设计上的散热,我们应该如何在设计端改善散热?
1,我们首先要搞懂一个问题:为什么要进行板级热设计?
PCB杨老师总结了大概有下面几个原因:
a,设备体积减小,功率上升,热流密度大幅增加.
b 高温对产品的不良影响: 元器件损坏(炸管);绝缘性能下降;材料老化严重: 焊缝开裂,甚至焊点脱落等等.
c, 高温对元器件的影响:电容寿命下降;电阻阻值变化;磁性器件绝缘材料性能下降;晶体管故障率上升.
d, 散热问题是制约产品小型化、轻便化的关键问题.
2,接着,我们要了解我们的研究对象,主要体现在下面三个方面,这里我们重点是关于第二个板级的热设计。
a, 元件级热设计:研究元器件内部结构及其封装形式对传热的影响,计算及分析元器件的温度分布。对材料、结构进行热设计,降低热阻,增加传热途径,提高传热效果,达到降低温度的日的。由元器件的生产厂家完成。
b, 电路板级的热设计:主要研究电路板的结构、元器件布局对元件温度的影响以及电子设备多块电路板的温度分布,计算电子元件的结点温度,进行可靠性设计。对电路板结构及其元器件进行合理安排,在电路板及其所在箱体内采取热控制措施,达到降低温度目的。
c, 环境级的热设计:研究电子设备所处环境的温度对其的影响,环境温度是电路板级的热分析的重要边界条件。采取措施控制环境温度,使电子设备在适宜的温度环境下工作。
3,最后就是最重要的,我们要知道从哪些方面去入手并进行热设计改善。
热量的传递有导热,对流换热及热辐射三种方式,所以基本上所有改善散热的方法都离不开这三种方式。
下面开始我们的核心内容,PCB设计上如何改善散热?
1,PCB布局设计上的散热设计:
a,整体的PCB板布局前,需要清楚PCB上热设计的风道是怎样的,热器件分散或者错开放置,风道上不要有高器件挡住风道。因为当沿着气流来流方向布置的一系列器件都需要加散热器时,器件尽量沿着气流方向错列布置,可以降低上下游器件相互间的影响。如无法交错排列,也需要避免将高大的元器件(结构件等)放在高发热元器件的上方。
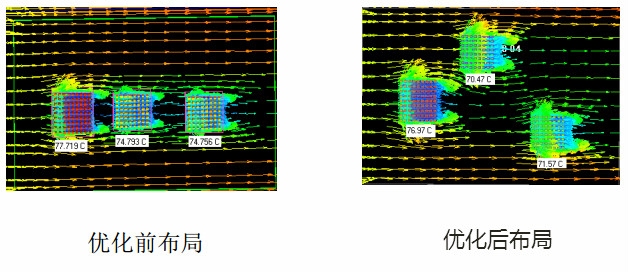
b,同一块印制板上的器件应尽可能按其发热量大小及散热程度分区排列,发热量小或耐热性差的器件(如小信号晶体管、小规模集成电路、电解电容等)放在冷却气流的最上流(入口处),发热量大或耐热性好的器件(如功率晶体管、大规模集成电路等)放在冷却气流最下游。
c, 对温度比较敏感的器件要注意布局的位置,比如一些温度规格较低的晶振和其他一些热敏感器件等,最好安置在进风口处或者温度最低的区域(如设备的底部),不要将它放在发热器件的正上方。
d, 当元器件的发热密度超过0.6W/cm3,单靠元器件的引脚及元器件本身已不足以充分散热,应考虑采用增加散热器或风扇等措施。
e, 对模块内部不能吹到风的PCB板,在布置元器件时,元器件与结构件之间要保持一定的距离,以利于空气流动,增强对流换热。
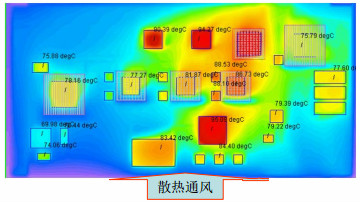
f,若考虑了散热片设计,带有导风方向要求的散热片要和风向一致,散热片下方不允许有热敏器件,测试器件和带有后期操作要求的器件。使用定位孔固定的散热片保持足够的区域没有任何高器件。
g,考虑增大散热面积和增强对流,对大功率器件可考虑加散热器,整机可用风扇等,另外还有水道设计等方式加强散热。

2,PCB布线上的散热设计
a,散热过孔设计
散热焊盘下加过孔散热的效果是明显的,这种散热过孔设计也用于绝大多发热大的器件上。散热过孔主要作用是层与层之间的热连接以及增加法向上的导热能力。对于热设计来说,真正起到散热作用的只有器件PAD底部的过孔和器件接地管脚旁边的几个过孔,这部分过孔的设计就非常重要。
一般情况下,散热最优的过孔设计方案为:孔径10~12mil,孔中心间距30~40mil,也可以根据器件的热耗水平和温度控制要求对过孔数量进行优化
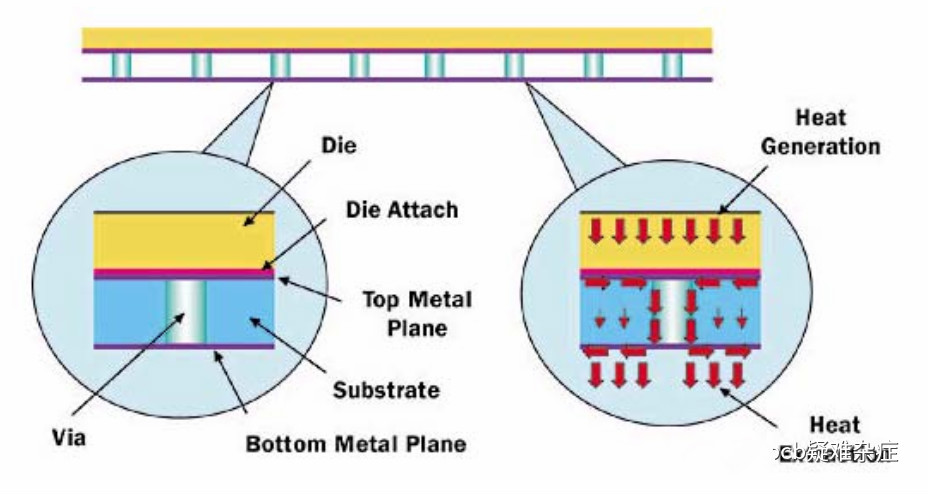
下面是增加散热孔和未增加散热孔的对比图

那散热焊盘背面塞孔或者开窗亮铜哪种效果好,如果塞孔会不会对散热有影响?单纯从导热系数的分析看,是否塞孔对导热系数影响很小。不塞孔容易产生漏锡,焊接面有空穴。焊锡漏到背面影响平整度。
b,增加散热铜箔设计
在做射频板我们经常遇到大面积铜箔开窗,其实就是为了散热。这里说的增加散热铜箔,包含了增大铺铜面积,增加铜箔铜厚,增加铜箔层数等等,都是增加散热铜箔的方式。
铜皮的作用是把局部传入电路板的热量扩展到更大的范围内,因此增加铜皮的厚度可以增强传热效果。板内铜皮只有连续的铜皮才能起到传递热量的作用,因此需要注意铜皮的分割。

c,IC散热焊盘加过孔后背面开窗亮铜也是增加器件散热的一种方式。
d,使用金属基板,通过局部金属基板混压的工艺,来达到局部散热的目的。
3考虑方便加工性的热平衡设计
a,贴片时由于散热速度快慢会引起应力差异,导致器件被应力拉动,产生立碑等不良;对于04020201这种小的分立器件两个引脚之间的应该尽量对称设计。
b,分立器件两个引脚尽量不要直接放置在大铜面上,避免散热过快导致焊接不良
c,通孔插件尽量设计成热焊盘,花连接,避免和多层平面全连接。这样导致的结果 焊盘散热过孔器件引脚不容易上锡。

















